0. 반도체 패키징 Lead frame, BGA
오늘 주제에 앞서 반도체 패키지에 대한 이해가 필요합니다. 반도체 소자를 만들고 인쇄회로기판(PCB)에 부착을 해야 비로소 패키징 공정이 완성이 되는데, 반도체 소자를 PCB에 부착하는 방법으로는 크게 리드프레임(lead frame), BGA(Ball Grid Array)가 있습니다.
리드프레임은 반도체 칩을 wire을 통해 lead frame에 연결한 후, PCB에 부착시키는 것을 말합니다. 초기 반도체들은 크기도 작고 리드프레임과 연결하는 wire의 수도 많지 않아서 많이 사용했으나, 점점 전자제품이 소형화, 고도화되면서 리드프레임의 한계가 드러났습니다. 새로운 반도체 패키징의 필요성이 대두되면서 등장한 것이 BGA입니다. PCB기판 하단에 수많은 ball을 통해 칩과 연결되게 하면서 더 많은 전기적 연결이 가능해졌고, 성능이 급속도로 향상되었습니다.
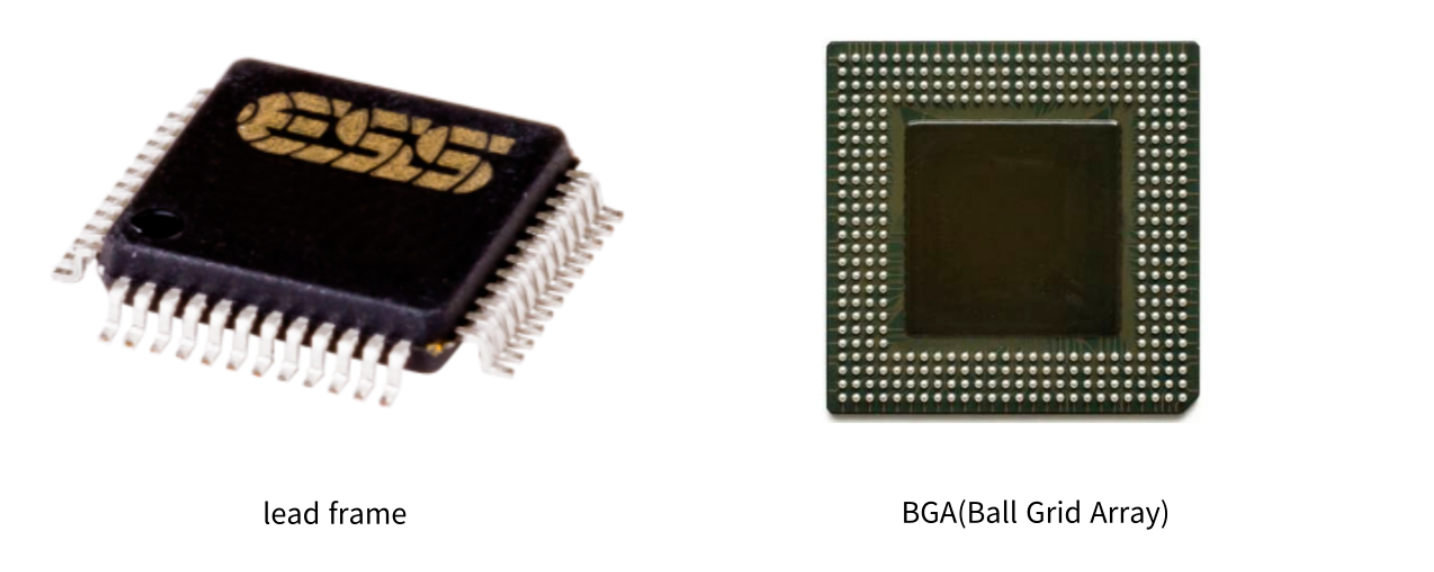
1. 솔더볼(solder ball)과 솔더 패드(solder pad)

솔더볼은 작은 구슬 형태의 납 소재로, 반도체 칩의 하부에 위치하거나 볼그리드 어레이(BGA, Ball Grid Array)패키지에서 칩과 PCB간의 연결을 담당하는 것을 말합니다.
솔더 패드는 PCB 상에 위치한, 납으로 된 평면적인 영역입니다. 반도체 칩이나 다른 부품이 PCB에 부착되는 곳으로 사용됩니다. 솔더패드는 솔더볼이 녹아서 흐를 때, 솔더를 잡아 붙이는 역할을 합니다. 따라서 솔더패드의 품질과 솔더볼과의 정확한 정렬이 부품 결합의 품질에 큰 영향을 미칩니다.
리플로우(reflow)공정 중 반도체 칩에 붙어있는 솔더볼이 녹아서 PCB에 있는 솔더패드와 연결됩니다.
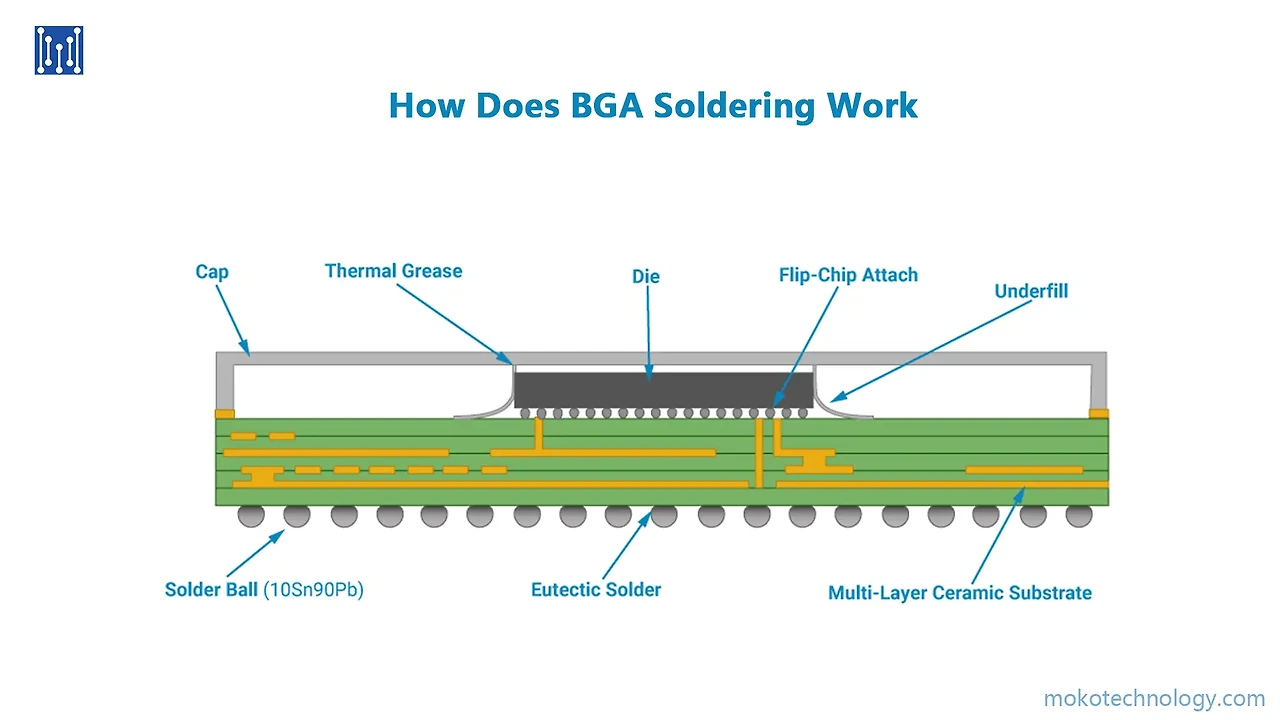
2. non wet 불량
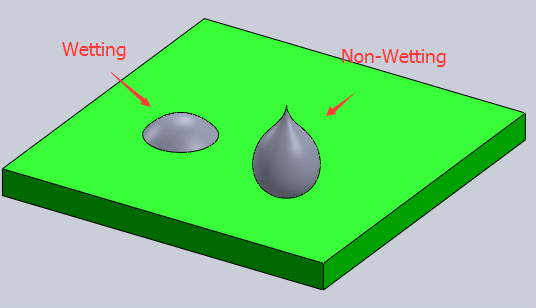
솔더볼이 잘 올라가 있는 상태에서 소자나 칩을 올림 열을 가하면 솔더가 녹으면서 결합이 되어야 하는데, 결합이 잘 이루어지지 않는 경우를 non-wet 불량이라고 합니다. 쉽게 말해서 '실장이 안되어 있다'라는 의미로 솔더볼이 소자의 납패드와 충분히 결합되지 않거나 납이 납패드에 충분히 흘러들지 않은 상태를 나타냅니다. non wet에는 여러가지 원인이 있습니다.
- Oxide Layer (산화 층): 솔더는 공기 중의 산소와 반응하여 산화되는 경향이 있는데, 솔더볼이나 솔더패드가 산화되면, 솔더가 충분히 흐르지 않아 non-wet 불량이 발생할 수 있습니다.
- 표면 재료 및 적층 : 솔더볼이나 솔더패드의 표면에 사용된 재료가 부적절하거나 납패드와 솔더볼 사이에 적절한 적층이 이루어지지 않은 경우에도 non-wet 불량이 발생할 수 있습니다.
- 프로세스 제어 부족 : 솔더링 프로세스에서 온도, 흐름 및 기타 조건을 적절하게 제어하지 못하면 non-wet 불량이 발생할 수 있습니다.
- 플럭스의 부적절한 사용 : 솔더 작업 중에 플럭스(flux)를 사용하는데, 플럭스의 양이나 종류가 부적절하면 non-wet 불량이 발생할 수 있습니다. 플럭스는 솔더 작업 시 솔더볼과 솔더패드 사이의 산화를 방지하고 솔더의 흐름을 촉진하는 역할을 합니다.
.